服务描述
1. 电镀原理
电镀是指利用电解的方法使金属或合金沉积在被镀件表面,以形成均匀、致密、结合力良好的金属层的过程。电镀金的阳极一般采用铂金钛网材料,当电源加在铂金钛网(阳极)和镀件(阴极)之间时,溶液会产生电流,并形成电场。阳极发生氧化反应释放出电子,同时阴极得到电子发生还原反应。阴极附近的络合态金离子与电子结合,以金原子的形式沉积在镀件表面。镀液中的络合态金离子在外加电场的作用,向阴极定向移动并补充阴极附近的浓度消耗。电镀的主要目的是在镀件上沉积一层致密、均匀、无孔洞、无缝隙、无其它缺陷的金。
2. 应用范围
电镀金层具有接触电阻低、导电性能好、可焊性好、耐腐蚀性强,因而电镀金在集成电路制造中有着广泛的应用。例如:在驱动IC封装中普遍使用电镀金凸块;在CMOS/MEMS中应用电镀金来制作开关触点和各种结构等;在雷达上金镀层作为气桥被应用;电镀还被用于晶圆级封装领域的TSV、UBM等的制作,以及用于各种引线键合的键合面等等。
3. 一般工艺过程
1) 在基片上溅射Ti/Au、TiW/Au等金属作为电镀的种子层;
2) 涂布光刻胶,光刻显影出电镀所需的图形;
3) 清洗后进行电镀金;
4) 去除光刻胶;
5) 蚀刻图形以外的种子层;
4. 设备和镀金照片

晶圆电镀台
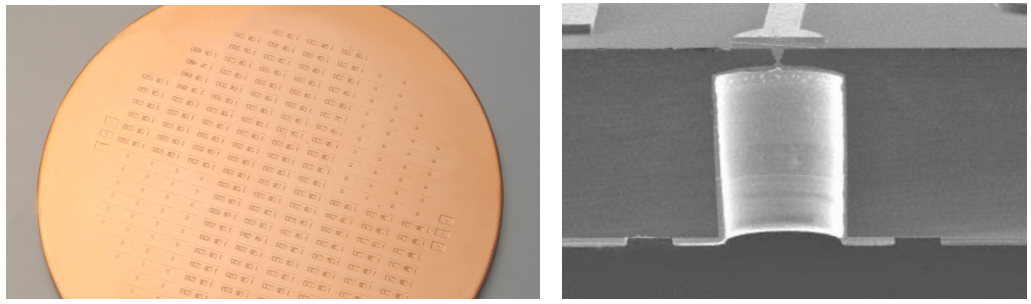
晶圆电镀金
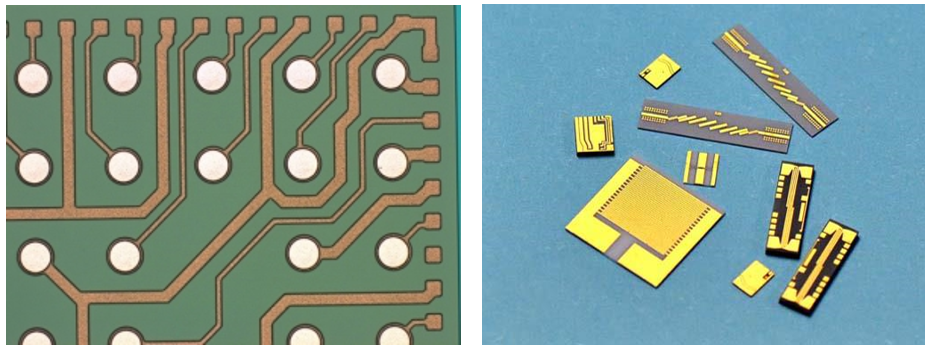
精细线路电镀金
5. 技术指标
1)金属化体系
构成 | 厚度 |
金(Au) | 1~6um |
镍(Ni) | 0.10~0.20um |
钛钨(TiW) | 0.08~0.12um |
氮化钽(TaN) | 0.02~0.06um |
2)图形化
项目 | 参数 |
最小线宽 | 0.02mm |
最小缝宽 | 0.02mm |
线缝误差 | ±0.002mm |
套刻精度 | <0.01mm |
3)性能
项目 | 参数 |
方阻范围 | 20~100Ω/□ |
电阻精度 | <±10% |
电阻温度系数 | <±150ppm/℃ |
电极耐温特性 | 400℃×10min |
4)不同金属化的焊接方式
金属结构 | 功能 | 适用焊料 |
TiW/Au | 提供微带线 | AuSn AuGe AuSi导电胶 |
TaN/TiW/Au | 微带线电阻器 | AuSn AuGe AuSi导电胶 |
TiW/Ni/Au | 提供微带线 | AuSn AuGe AuSi PbSn导电胶 |
TaN/TiW/Ni/Au | 微带线电阻器 | AuSn AuGe AuSi PbSn导电胶 |
5)通孔金属化
提供氧化铝基板电路的通孔金属化,以方便接地,通孔电阻小于等于50毫欧姆。 可加工的金属化通孔最小直径为0.1mm,基片厚度与孔径的标准比例是1:1,薄膜基片所能承受最小比例是0.6。最小孔距为0.8×基片厚度×2;孔边缘到导体带线的最小距离是63.5微米;孔到基片边缘的最小距离是0.8×基片厚度×1.5;孔位最小偏差为50微米。

通孔规范示意图
6. 客户需提供的加工信息
1)单步镀金需求:基片类型和尺寸;单面/双面/通孔;镀金厚度;图形有效面积等必要信息。
2)镀金电路定制加工服务:基片类型、尺寸和数量;加工图纸;镀金厚度和精度要求等必要信息。
7. 加工基本收费
1)晶圆镀金:600-1500/样
2)复杂定制化加工服务:4000/样起
项目介绍
样品要求
/
结果展示
微信扫码直接开聊
关注我们



 绑定微信时刻了解进展
绑定微信时刻了解进展































